
- 42 高校采购信息
- 875 科技成果项目
- 1 创新创业项目
- 0 高校项目需求
激光超声耦合的微连接工艺
随着集成电路领域的发展,电子元器件呈现出小型化及高度集成化的特点;为了确保电子元器件工作的稳定性与可靠性,需要对电子元器件进行良好的封装,一方面,可以减少电子元器件的机械振动损伤,另一方面,可以保证良好的真空性与气密性。现有的封装方法包括热压键合与表面活化键合,热压键合是通过对键合界面加热、施压,使得原子间发生相互扩散、重结晶实现连接;然而热压键合工艺温度通常达到300 ℃以上,高温会使得键合接头中热应力提高,降低连接强度,且容易对热敏元件造成损伤;表面活化键合是通过高能粒子束轰击键合界面,去除表面的氧化层及污染物从而获得高活性的材料表面,施加压力即可在室温下实现牢固的键合,然而表面活化键合的工艺复杂,对设备要求较高。
近年来,采用激光为热源的微连接技术逐渐成熟,打破了高能量密度激光对IC芯片造成热损伤的刻板印象。由于激光能量高度集中,在合理调整工艺参数的情况下,能够实现对封装结构的选择性精密加热,并严格控制热影响区的大小。有效地避免了互连过程中热输入对热敏元件造成的损坏,从而提高了封装结构的可靠性。
本成果解决了现有技术中,采用激光为热源的微连接技术无法保障微连接焊点力学性能,无法保证封装的气密性的缺陷。通过将激光作为瞬态液相键合的热源,并将超声波介入瞬态液相键合的反应过程,保证电子元器件性能的同时,加快了瞬态液相键合的反应进程,提升了电子元器件封装的稳定性、可靠性及效率,且该基于激光超声耦合的微连接工艺具有良好的适应性。
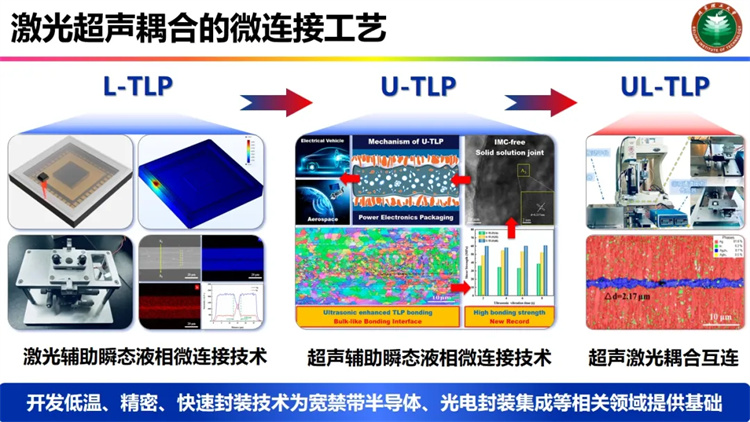
热敏元器件、红外探测器及晶圆级气密性封装领域、微连接技术领域等。
我国电子信息制造业正以前所未有的速度向高端化、智能化方向迈进,关键环节技术的持续突破成为引领产业升级的强大引擎。随着国家经济的快速发展和民众生活水平的提升,下游应用如半导体、显示面板、消费电子、新能源汽车等对相关技术设备的需求日益增长,提供了巨大的市场潜力。
在微型时代,激光微连接已经发展成为一种预期的更小规模的制造工艺。激光技术领域的最新发展为激光加入微系统中使用的各种材料带来了新的机遇,激光微连接具有作为微型封装应用的潜力。
本成果可满足制冷型红外探测器等信息量子功能材料器件的一体化封装技术需求。有效地避免了互连过程中热输入对热敏元件造成的损坏,提高了封装结构的可靠性,降低损耗节约成本。

扫码关注,查看更多科技成果








